微纳加工
微纳加工硅通孔(TSV)技术-硅通孔是未来关键技术的代表之一,它们是实现大型3D封装的关键促成因素。利用硅通孔降低路由复杂性、提高集成度,同时维持甚至缩小所占空间。铜制硅通孔可显著提高电气性能——射频领域特别要求使用。原位芯片TSV工艺能力:
• 通孔直径: 20-30um
• 深宽比:10:1
• 通孔材料:铜,金
• 通孔状态:实心孔,空心孔
-原位芯片可根据您的产品特定设计要求为根本依据来优化您的定制解决方案。
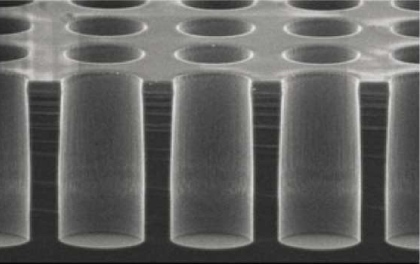
微纳加工MEMS硅插入器- MEMS硅插入器是用于3D集成和晶圆级封装的多层印刷电路板的下一步计划,可在极小的空间内实现电气连接。- 插入器可能包含复杂的电气路径和修改路径传输和/或重新定义来自微型器件的信号的相关电路,并依次与额外组件甚至整个系统相连接。- 通过额外印刷电路板将线路长度和所占空间缩小了10倍。
微纳加工密封晶圆级封装(WLP)- 晶圆级封装(WLP)已从MEMS设计和制造方面的特点变成了基本要求。随着技术要求的融合,将不同工艺技术和模块整合至晶圆级单个器件内现已变得司空见惯。实际上,国外的IMT超过80%的项目均采用晶圆级封装,有些项目的集成和小型化所需的晶圆多达5片。- 采用硅、玻璃、石英、金属等材料及其他材料制造这些器件,且通常会融入和搭配其他技术模块(如IMT的硅通孔)来简化路由和向外界发送信号。- IMT晶圆级封装(包括针对需要高真空封装的应用进行次毫乇级真空晶圆级封装)的气密性往往达99%以上。- IMT在需要将4-5片晶圆叠合在一起的多个生产项目中均采用晶圆级封装技术。- IMT开创了通过晶圆级封装实现工艺和技术的复杂集成的先河,是该行业的佼佼者。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图