微纳加工
分享光刻加工中电子束光刻设备参数,对光刻工艺工程师可以使用不同设备时有和好的适应性。光刻加工不仅需要对工艺有熟练的要求,对设备的良好使用也是有一定的使用要求。以下参考国外某电子束光刻设备。
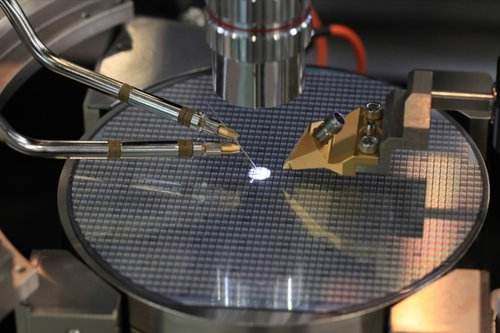
1.能力/光刻表现
最小特征尺寸:
100 kV(高精度写入模式):≤ 8 nm
100 kV(高速写入模式):≈ 50 nm
2.叠加精度:
高分辨率写入模式 ≤ ± 20 nm
高速写入模式 ≤ ± 35 nm
3.现场拼接精度:
高分辨率写入模式 ≤ ± 20 nm
高速写入模式 ≤ ± 30 nm
4.光束定位精度:
高分辨率写入模式 = 0.125 nm
高速写入模式 = 2 nm
5.写功能:
直写和叠写:重叠检测晶圆上的标记
口罩制作:在口罩坯料上曝光
字符书写:字母、数字和 24 个符号
字符尺寸:1 毫米 X 1 毫米
字符行:最多 4
循环校正曝光:剂量校正、光束位置校正、光束偏转系统校正
非平面基板图案化:
最大限度。非平面基板的高度变化 = 10 mm
最小。特征尺寸 ≥ 50 nm
6.硬件细节
电子束:
光束形状:点光束
加速电压:100 kV
光束电流:500 pA 至 20 nA
最小光束尺寸:≤ 2.9 nm(100 kV 高分辨率写入模式)
光束偏转:
方法:矢量扫描
高速写入模式下的写入区域:1 mm X 1 mm
高精度写入模式下的写入场:62.5 µm X 62.5 µm
光束定位DAC:19位
光束扫描 DAC:12 位
光束扫描速度:50 MHz
7.舞台运动:
方法:一步一步重复
载物台位置测量:激光干涉仪
位置步长:λ/1024 (0.62 nm)
载物台移动范围:190 X 170 mm
书写区域:150 X 150 毫米
移动速度:高达 10 毫米/秒
材料转移:
带 10 个磁带装载系统的自动装载机
基材要求
从 5 毫米 X 5 毫米到 150 毫米晶圆的零件;5" 和 6" 面罩毛坯
允许使用 Si、III-V、金属、电介质
基板必须直接安装到正确的卡匣上
在光刻加工中,电子束光刻工具有一个特定的最大区域,它可以为固定的平台位置写入,称为写入场。通常,它们的范围从几十微米到 1-2 毫米不等。如果要曝光的图案大于写入场的大小,则电子束被消隐,载物台移动 1 个写入场的距离并继续写入。为避免写入场之间的不连续或重叠(称为场拼接错误),电子束光刻系统具有激光干涉测量台定位系统,允许以纳米级精度拼接场。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图