微纳加工
MEMS代工中的光刻通常是通过选择性地暴露于诸如光的辐射源而将图案转移至光敏材料。光敏材料是当暴露于辐射源时经历其物理性质变化的材料。如果我们选择性地将光敏材料暴露于辐射下(例如,通过屏蔽某些辐射),则材料上的辐射图将转移到已暴露的材料上,因为已曝光和未曝光区域的特性不同。
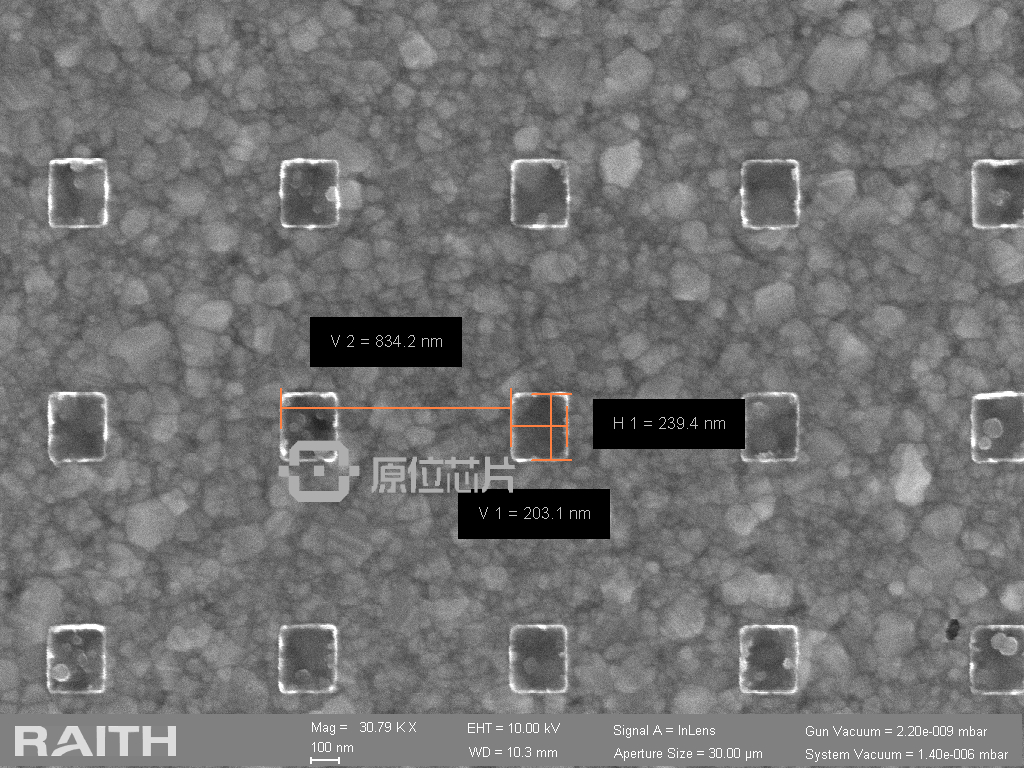
在用于MEMS代工的光刻中,所使用的光敏材料通常是光致抗蚀剂(也称为抗蚀剂,也使用其他光敏聚合物)。当抗蚀剂暴露于特定波长的辐射源时,抗蚀剂对显影剂溶液的化学耐受性改变。如果在选择性暴露于光源后将抗蚀剂置于显影剂溶液中,它将蚀刻掉两个区域(已曝光或未曝光)之一。如果曝光的材料被显影剂蚀刻掉,并且未曝光的区域具有弹性,则该材料被认为是正性抗蚀剂。如果曝光后的材料对显影剂具有弹性,并且未曝光的区域被蚀刻掉,则可以认为它是负性抗蚀剂。
光刻是MEMS代工中图案定义的主要机制。光敏化合物主要是有机的,并且不包括微机械师感兴趣的材料特性范围。然而,由于该技术能够以经济的方式产生精细的特征,因此在蚀刻底层时光敏层通常用作临时掩模,从而图案可以被转印到底层上。光刻胶也可以用作模板,以构图在光刻之后沉积的材料。抗蚀剂随后被蚀刻掉,并且沉积在抗蚀剂上的材料被“剥离”。
与将抗蚀剂图案用作蚀刻掩模相比,用于将图案从抗蚀剂转移到另一层的沉积模板(剥离)方法不常见。原因是抗蚀剂与大多数MEMS沉积工艺不兼容,通常是因为它不能承受高温并且可能会成为污染源。
一旦将图案转移到另一层,通常将抗蚀剂剥离。这通常是必要的,因为抗蚀剂可能与后续的微加工步骤不兼容。这也使形貌变得更加引人注目,这可能会妨碍进一步的光刻步骤。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图