微纳加工
MEMS代工中的光刻,科研人员了对光刻进行一些假设。首先,假设存在一个特性良好的模块,该模块具有以下功能:准备晶片表面,沉积所需的抗蚀剂厚度,完美对准掩模,以最佳剂量曝光晶片,在最佳条件下显影抗蚀剂并烘烤用于在序列中适当位置的适当时间。不幸的是,即使模块执行得很好,光刻的特性也非常取决于特征和地形。因此,MEMS代工设计人员必须意识到光刻的某些局限性,以及他们应提供给执行光刻的技术人员的信息。
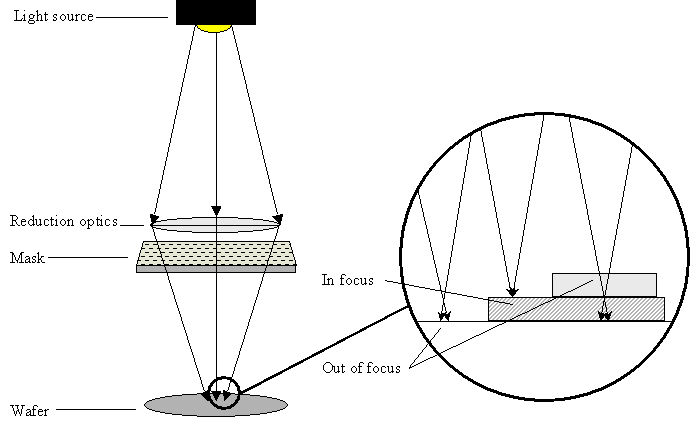
MEMS代工设计师通过选择材料,地形和几何形状来影响光刻工艺。在其上沉积抗蚀剂的材料很重要,因为它会影响抗蚀剂的附着力。光致抗蚀剂下面的层的反射率和粗糙度决定了曝光期间存在的反射光和分散光的量。难以在具有高形貌的表面上获得良好的均匀抗蚀剂涂层,这使曝光和显影变得复杂,因为抗蚀剂在不同位置具有不同的厚度。如果晶片表面具有许多不同的高度特征,那么大多数光刻曝光工具的有限焦点深度将成为问题。
MEMS代工设计人员应牢记所有这些限制,并进行相应的设计。例如,在可能的情况下,明智的做法是最后执行非常高的纵横图样化步骤(光刻和随后的蚀刻/沉积),因为生成的形貌通常会妨碍其他任何光刻步骤。设计人员还必须弄清楚哪个焦平面对他们来说最重要(请记住,距离焦平面Z远的特征将经历最差的聚焦)。分辨率测试结构应位于此级别(因为晶圆厂将使用它们来检查照相步骤的质量)。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图