微纳加工
在MEMS代工中,时常会遇到光刻加工的需求。而光刻是作为功能齐全的模块的一部分执行的,该模块包括晶片表面准备,光致抗蚀剂沉积,掩模和晶片的对准,曝光,显影以及适当的抗蚀剂调节。光刻工艺步骤需要按顺序进行表征,以确保模块末端的剩余抗蚀剂是掩模的最佳图像,并具有所需的侧壁轮廓。
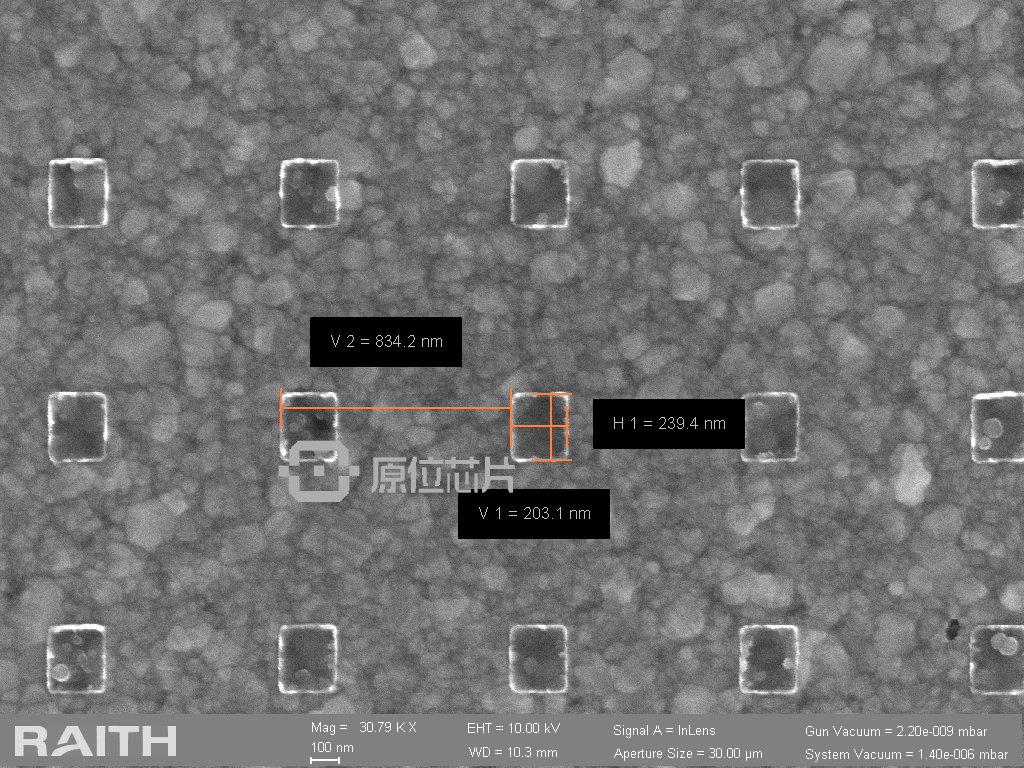
MEMS代工中,在光刻模块中找到的标准步骤依次是:脱水烘烤,HMDS底涂,抗蚀剂旋转/喷涂,软烘烤,对准,曝光,后曝光烘烤,显影硬烘烤和脱渣。并非所有的光刻模块都将包含所有工艺步骤。为了完整起见,还包括对过程步骤的简要说明。
·脱水烘烤-使晶片脱水以帮助抵抗粘附。
·HMDS底漆-用粘合促进剂涂覆晶片表面。并非所有表面都是必需的。
·抗蚀剂旋转/喷涂-通过旋转或喷涂在抗蚀剂上涂覆晶片。通常需要一件均匀的外套。
·软烘烤-去除抗蚀剂中的某些溶剂,可能会导致抗蚀剂质量(和厚度)的大量损失。使抵抗力更加粘稠。
·对齐-将掩模上的图案与晶圆上的特征对齐。
·曝光-掩模图像在抗蚀剂上的投影会引起选择性的化学性质变化。
·曝光后烘烤-烘烤抗蚀剂以驱除更多的溶剂。使抗蚀剂对蚀刻剂(显影剂除外)更具抵抗力。
·显影-曝光后有选择地去除抗蚀剂(如果抗蚀剂为正,则曝光的抗蚀剂;如果抗蚀剂为正,则未曝光的抗蚀剂)。通常是湿法工艺(尽管存在干法工艺)。
·硬烘烤-从抗蚀剂上清除掉大部分剩余的溶剂。
·脱胶-去除可能堵塞图案中开放区域的抗蚀剂浮渣薄层,有助于打开角落。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图