微纳加工
Micralyne公司可以提供MEMS加工技术,干蚀刻和湿蚀刻金属沉积、化学气相沉积、电镀、硅片研磨抛光、晶圆键合等关键技术也称为其业务重点。关于MEMS加工中的刻蚀工艺,Micralyne有着自己独特的优势。
MEMS加工--DRIE(深反应离子蚀刻)
·高深宽比(深宽比高达50:1,侧壁角89.5°至89.8°,蚀刻速率高达16 µm / min,蚀刻深度<1μm至> 1000 µm)
·正剖面和各向同性蚀刻
·经验证的热敏膜或镜面释放蚀刻工艺
·晶圆蚀刻的丰富经验
·真空胶带粘结,用于晶圆蚀刻
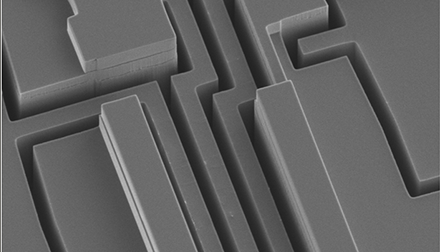
图片源自Micralyne
MEMS加工--RIE –(反应离子蚀刻)
·硅,石英,氧化物,氮化物,多晶硅,氮氧化物,Ti,TiW,Nb
·KOH / TMAH掩模蚀刻层的晶圆边缘保护
·深沟槽氧化物刻蚀(用于去除硅沟槽底部的氧化物,长宽比高达10:1)

图片源自Micralyne
·硅各向同性蚀刻(目标的深度控制为±〜3 µm)
·从0.4 µm到300 µm的玻璃各向同性蚀刻(16 µm蚀刻的深度控制为±0.2 µm,玻璃CD:90 µm±3 µm)
·HF氧化物牺牲蚀刻
·Lift-off
·薄膜蚀刻(金属和电介质)
·标准湿洗工艺(酸,碱和溶剂)
·先进的湿法工艺,例如旋转蚀刻机,兆频超声和循环浴
·临界点干燥机
苏州原位芯片可以提供MEMS加工刻蚀业务。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图