微纳加工
MEMS加工中往往会遇到键合和TSV通孔的需求,我们一起看看IMT可以为客户提供这些MEMS加工的具体内容是哪些。
晶圆键合是晶圆级密封包装或创建3-D微流控设备所需的关键功能。IMT的键合使气密和真空晶圆级封装可以降低后处理芯片级封装的成本,并提高MEMS的性能和可靠性。在IMT生产的所有晶圆中,有超过50%是晶圆粘合的。
特定能力
IMT会根据客户的需求紧密合作,以确定包括以下内容的绑定方法:
·Au-Au热压
·玻璃料
·阳极的
·融合
·金属合金(低温)
·聚合物
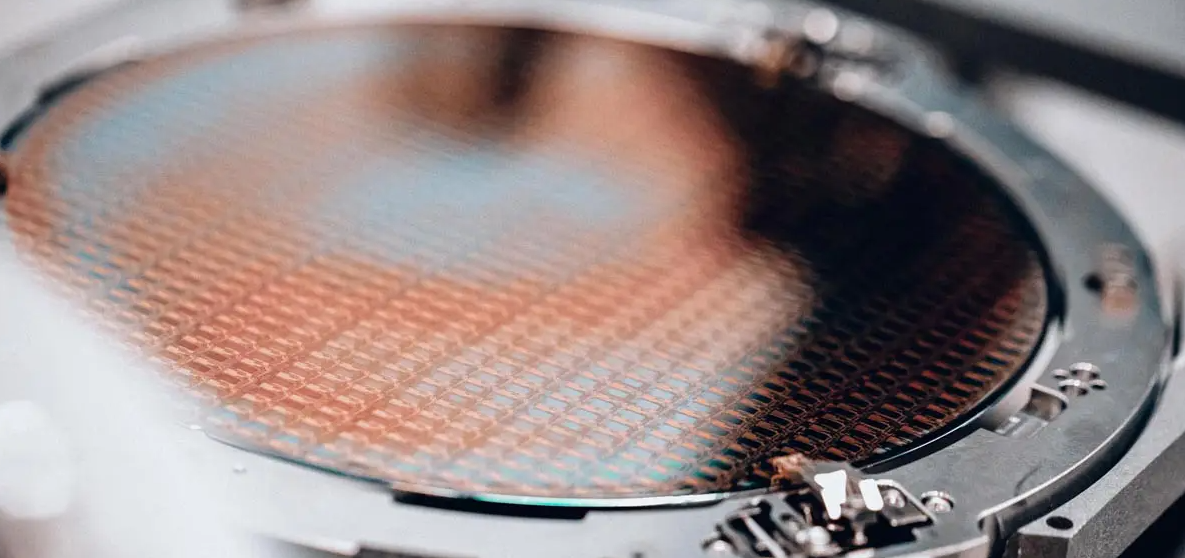
图片源自IMT
根据键合方法和气密性要求,功能包括:
·使用吸气剂的Sub-1 mTorr高真空粘结
·生产中的气密性> 99%–通过探测板载热敏电阻验证了气密性
·真空,大气压或具有独特气体的分压
聚合物键合:
尽管不是密封的,但聚合物键合可用于制造微流体,从而形成流体通道。通常,可以结合使用多种粘合方法以获得所需的最终包装。除了密封性要求外,其他注意事项还包括:
·设计/设备占地面积
·温度预算
·所用材料
·最终包装和环境要求
粘接后,保护晶圆不受环境影响,并保护易碎的MEMS结构。这些晶片可以通过芯片分割和芯片级封装而继续前进。
硅通孔(TSV)代表了未来的关键技术,因为它们是实现大规模3D集成的关键推动力。因为它们允许电信号通过基板,所以它们使设备尺寸更小,信号路径更短。IMT与TSV已有多年合作,如今生产的产品中每个晶片有将近14万个密封金属填充的TSV。IMT的客户使用TSV来降低路由复杂性,并在保持或在某些情况下缩小占地面积的同时提高集成度。
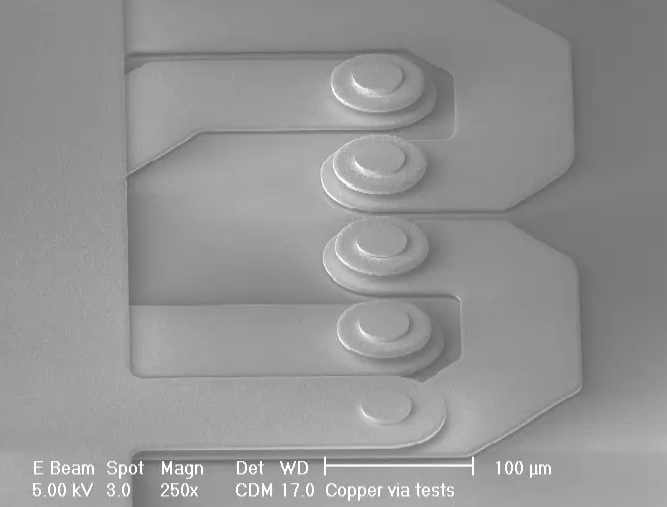
图片源自IMT
铜TSV可以极大地改善电气性能,这是RF世界特别要求的。IMT的铜TSV技术可提供:
·每个通孔的直流电阻小于0.01欧姆
·6 GHz时-0.01 dB的插入损耗
·直径15 µm x深度50 µm
·直径50 µm x深度250 µm
根据您产品的特定设计要求,IMT的TSV平台为优化您的定制解决方案提供了基础。
MEMS Si中介层是用于3D集成和晶圆级封装的多层PCB的下一步,可在非常小的占位面积上实现电连接。
插入器可能包含复杂的电气路径和电路,这些电路和电路会重新路由和/或重新表征来自微型设备的信号,进而与其他组件或整个系统连接。与传统PCB相比,线条和空间减少了10倍。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图