微纳加工
微纳加工中有一项TSV硅通孔工艺。这个技术不是一种封装技术,而是一种重要的工具。TSV硅通孔技术会是将半导体集成电路冲向3D SiP时代的关键一步。
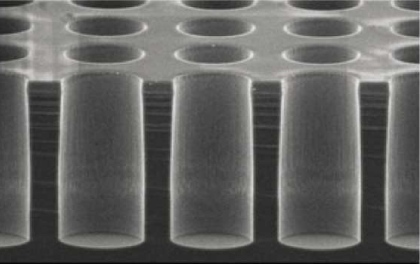
在微纳加工中大部分人认为TSV硅通孔是一种封装技术,让半导体裸片和晶圆以较高的密度连接在一起。TSV和WLCSP 相结合,工艺流程上可以先钻孔和后钻孔。具体的流程基本包含以下:贴膜–打磨–蚀刻–绝缘层处理–钻孔–溅镀–贴装–切割。采用TSV工艺后,封装流程就放弃了金属引线键合工艺,而增加了蚀刻和钻孔等步骤。
为什么说TSV硅通孔技术是3D SIP的关键?尽管3D封装可以通过引线键合、倒装(Flip Chip,FC)凸点等各种芯片通路键合技术实现,但TSV技术是潜在集成度最高、芯片面积/封装面积比最小、封装结构和效果最符合SiP封装要求、应用前景最广的3D封装技术,被誉为是继引线键合、TAB、FC之后的第四代封装技术,TSV也被称为终极三维互联技术。所以,硅通孔TSV技术是半导体集成电路产业迈向3D SiP时代的关键技术。
研究表明从2011年开始,TSV技术就已开始渗透到DSP、NAND Flash、DRAM、RF 等芯片领域;未来,基于TSV技术的3D-SiP封装将进一步应用至CPU、GPU、传感器、MEMS等各类领域。TSV硅通孔技术将成为3D SiP的主流封装技术。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图