微纳加工
MEMS代工中的TSV技术是3D集成的MEMS关键技术,一般可以有“Via-First”和“Via-Last”。两者的主要区别是在Bonding前后。“Via-First”TSV是在Bonding之前从而可以承受几百度的高温;而“Via-Last”TSV工序是在Bonding之后,必须在足够低的温度下进行,以防止损坏后端CMOS层。
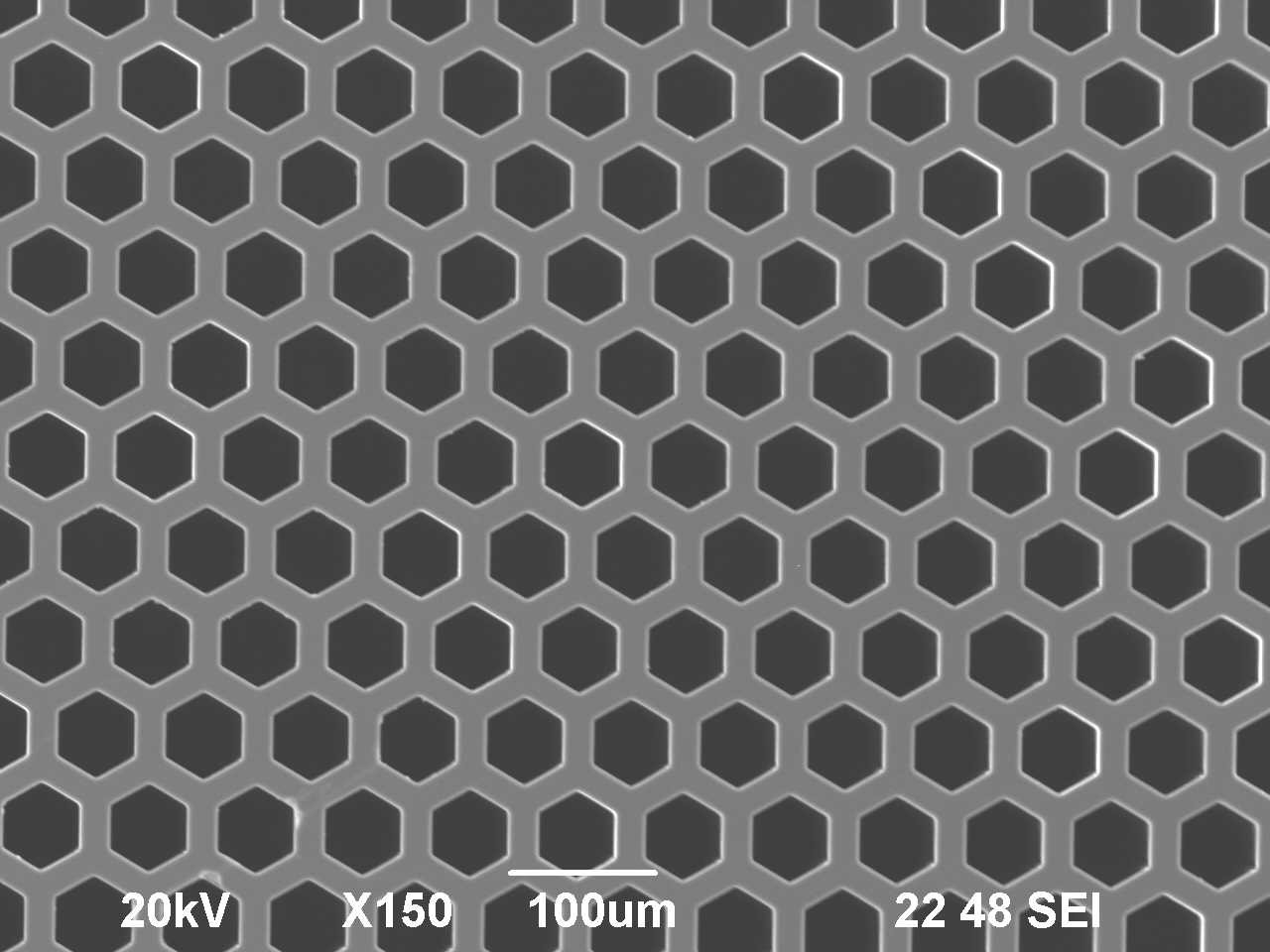
纯MEMS代工公司Teledyne DALSA 在TSV技术上就有自己成熟的经验。他们长期深耕在提供高深宽比 TSV(深度 > 400 µm)和高压运行、热氧化隔离,并且可以提供镍/钯镀层和深孔和标准切 割,而不需要“盘曝光”工序。Teledyne DALSA 在使用性能更高的铜填充工艺(阻抗更低、散热更好,可提高运行频率和功率密度)升级我们现有的先钻孔低阻抗 ISDP 填充工艺(430µm深度典型阻抗 < 1 Ohm、电容 < 10 pF)。 这种新型铜填充工艺十分适合使用高蚀刻速度 Bosch DRIE工艺进行量产,最高可以将 DRIE 工序成本降低50%。
纯MEMS代工的Teledyne DALSA 的Via-First TSV技术可以利用沟槽填充(in-situ doped poly原位掺杂多晶硅)作为导体,或者如果需要较大的通孔,MEMS芯片本身可以作为导电区,这时沟槽仅用于提供电隔离。在150mm和200mm晶圆上我们都可以提供这项技术。
MEMS代工在200mm晶圆的线上Teledyne DALSA 的Via-First TSV技术将采用铜通孔填充,这个技术使用的是Alchimer的低温电化学制程。该技术生产出仅5微米直径,100微米深的完美填充的通孔,利用铜重分布层和Ni / Au UBM作为与外界的导电连接。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图