微纳加工
MEMS代工中的刻蚀就是用化学的、物理的或同时使用化学和物理的方法,有选择地把没有被抗蚀剂掩蔽的那一部分薄膜层除去,从而在薄膜上得到和抗蚀剂膜上完全一致的图形。刻蚀技术主要分为干法刻蚀与湿法刻蚀。

干法刻蚀
在MEMS代工中干法刻蚀,把硅片表面曝露于气态中产生的等离子体,等离子体通过光刻胶中开出的窗口,与硅片发生物理或化学反应(或这两种反应),从而去掉曝露的表面材料。干法刻蚀是亚微米尺寸下刻蚀器件的最重要方法。
湿法刻蚀
用液体化学试剂(如酸、碱和溶剂等)以化学方式去除硅片表面的材料。湿法腐蚀一般只是用在尺寸较大的情况下(大于3微米)。湿法腐蚀仍然用来腐蚀硅片上某些层或用来去除干法刻蚀后的残留物。
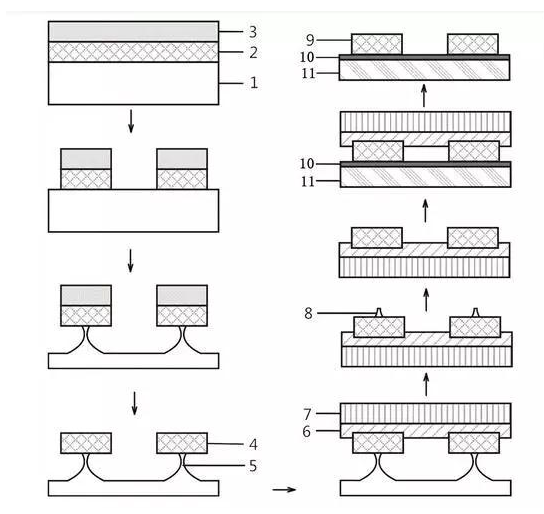
①各向异性刻蚀,即只有垂直刻蚀,没有横向钻蚀。这样才能保证精确地在被刻蚀的薄膜上复制出与抗蚀剂上完全一致的几何图形;
②良好的刻蚀选择性,即对作为掩模的抗蚀剂和处于其下的另一层薄膜或材料的刻蚀速率都比被刻蚀薄膜的刻蚀速率小得多,以保证刻蚀过程中抗蚀剂掩蔽的有效性,不致发生因为过刻蚀而损坏薄膜下面的其他材料;
③加工批量大,控制容易,成本低,对环境污染少,适用于工业生产。
干法刻蚀:
优点:能实现各向异性刻蚀,从而保证细小图形转移后的保真性。
缺点:造价高,用于微流控芯片制备的较少。
湿法刻蚀:
优点:适应性强,表面均匀性好、对硅片损伤少,几乎适用于所有的金属、玻璃、塑料等材料。
缺点:图形刻蚀保真不理想,刻蚀图形的最小线宽难以掌控。
原位芯片目前掌握离子束刻蚀、深硅刻蚀、反应离子刻蚀、聚焦离子束等刻蚀技术,可以刻蚀硅、氧化硅、氮化硅、金属、石英等材料。深硅刻蚀最大深宽比20:1,刻蚀精度高,线宽小。
苏州原位芯片科技有限责任公司©版权所有 苏ICP备15018093号-6 苏公网安备 32059002002439号 网站地图